SMT používá konvenční pájecí pastu pro analýzu dutin a řešení svařování vzduchem reflow (edice Essence 2023), zasloužíte si to!
1 Úvod

Při sestavování desky plošných spojů se nejprve na pájecí plošku nanese pájecí pasta a poté se na ni nanesou různé elektronické součástky. Nakonec se po přetavovací peci roztaví cínové kuličky v pájecí pastě a všechny druhy elektronických součástek a pájecí ploška desky plošných spojů se svaří dohromady, čímž se provede sestavení elektrických submodulů. Technologie povrchové montáže (SMT) se stále častěji používá u produktů s vysokou hustotou pouzder, jako jsou systémová pouzdra (SiP), součástky s kuličkovým gridarray (BGA) a napájecí holého čipu, čtvercového plochého bezpinového pouzdra (quad AA/No-lead, označované jako QFN).
Vzhledem k vlastnostem procesu svařování pájecí pastou a materiálů se po reflow svařování těchto zařízení s velkým pájeným povrchem v oblasti pájení vyskytnou otvory, které ovlivní elektrické, tepelné a mechanické vlastnosti výrobku a dokonce povedou k jeho selhání. Zlepšení dutiny pro reflow svařování pájecí pastou se proto stalo procesním a technickým problémem, který je třeba vyřešit. Někteří výzkumníci analyzovali a studovali příčiny dutiny pro svařování pájecích kuliček BGA a poskytli řešení pro zlepšení. Konvenční proces reflow svařování pájecí pastou s plochou QFN větší než 10 mm2 nebo s plochou svařování větší než 6 mm2 u holého čipu chybí.
Pro zlepšení svařovacího otvoru použijte svařování preformsolder a vakuové refluxní pece. Prefabrikované pájení vyžaduje speciální vybavení pro nanášení tavidla. Například tříska je po umístění třísky přímo na prefabrikovanou pájku výrazně odsazena a nakloněna. Pokud je pájená tříska přetavená a poté zahrotována, proces se dvakrát prodlouží a náklady na prefabrikovanou pájku a tavidlo jsou mnohem vyšší než náklady na pájecí pastu.
Vakuové refluxní zařízení je dražší, vakuová kapacita nezávislé vakuové komory je velmi nízká, poměr nákladů a výkonu není vysoký a problém s rozstřikováním cínu je závažný, což je důležitý faktor při použití produktů s vysokou hustotou a malou roztečí. V tomto článku je na základě konvenčního procesu reflow svařování pájecí pastou vyvinut a zaveden nový sekundární reflow svařovací proces pro zlepšení svařovací dutiny a řešení problémů s praskáním spojů a plastových těsnění způsobených svařovací dutinou.
2 Pájecí pasta, tisk, reflow, svařovací dutina a výrobní mechanismus
2.1 Svařovací dutina
Po reflow svařování byl výrobek testován rentgenem. Bylo zjištěno, že otvory ve svarové zóně se světlejší barvou jsou způsobeny nedostatečným množstvím pájky ve svarové vrstvě, jak je znázorněno na obrázku 1.
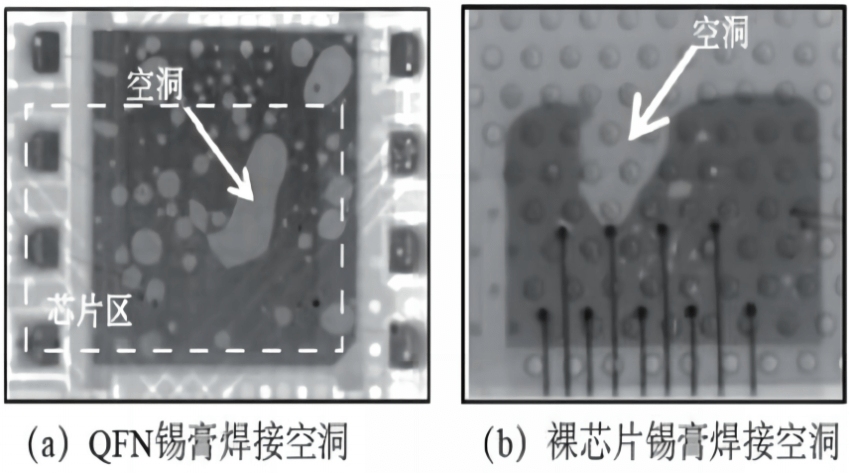
Rentgenová detekce bublinového otvoru
2.2 Mechanismus vzniku svařovací dutiny
Jako příklad pájecí pasty sAC305 je uvedeno hlavní složení a funkce v tabulce 1. Tavidlo a cínové kuličky jsou spojeny dohromady do tvaru pasty. Hmotnostní poměr cínové pájky k tavidlu je přibližně 9:1 a objemový poměr je přibližně 1:1.

Po nanesení a upevnění pájecí pasty s různými elektronickými součástkami prochází pájecí pasta při průchodu refluxní pecí čtyřmi fázemi: předehříváním, aktivací, refluxem a chlazením. Stav pájecí pasty se také liší v závislosti na teplotě v různých fázích, jak je znázorněno na obrázku 2.
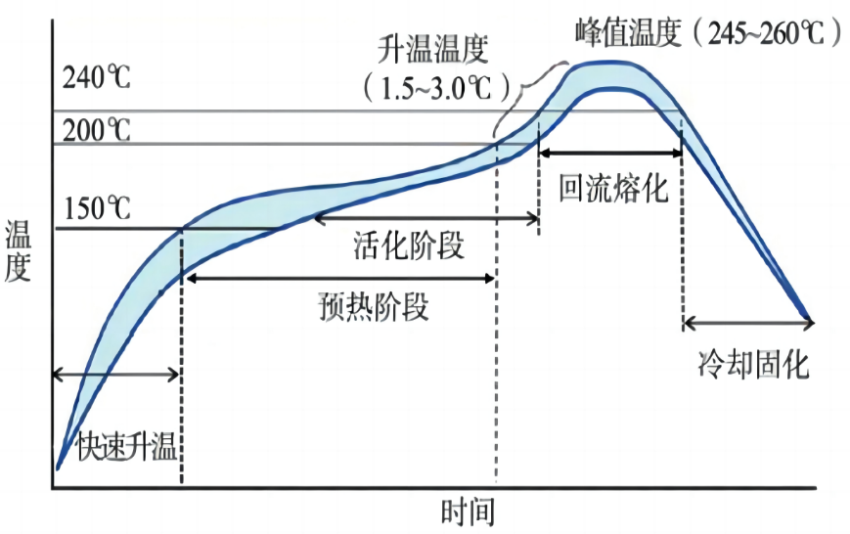
Referenční profil pro každou oblast pájení reflow
Ve fázi předehřívání a aktivace se těkavé složky tavidla v pájecí pastě při zahřívání odpaří do plynu. Současně se při odstraňování oxidu z povrchu svarové vrstvy vytvářejí plyny. Část těchto plynů se odpaří a opustí pájecí pastu, přičemž pájecí perličky se v důsledku odpařování tavidla pevně zhustí. Ve fázi refluxu se zbývající tavidlo v pájecí pastě rychle odpaří, cínové perličky se roztaví, malé množství těkavého plynu z tavidla a většina vzduchu mezi cínovými perličkami se včas nerozptýlí a zbytky v roztaveném cínu a pod napětím roztaveného cínu mají hamburgerovou sendvičovou strukturu a jsou zachyceny pájecí ploškou desky plošných spojů a elektronickými součástkami. Plyn obalený tekutým cínem je obtížné uniknout pouze vztlakem směrem nahoru. Horní doba tavení je velmi krátká. Když roztavený cín vychladne a ztuhne, ve svarové vrstvě se objeví póry a vytvoří se pájecí otvory, jak je znázorněno na obrázku 3.
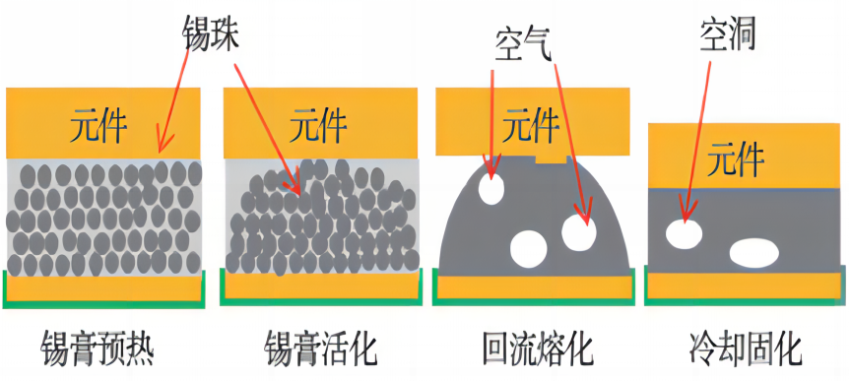
Schéma dutiny vytvořené přetavením pájecí pasty
Hlavní příčinou vzniku dutin při svarech je to, že vzduch nebo těkavý plyn obsažený v pájecí pastě po roztavení není zcela odveden. Mezi ovlivňující faktory patří materiál pájecí pasty, tvar nanesené pájecí pasty, množství nanesené pájecí pasty, teplota zpětného toku, doba zpětného toku, velikost svaru, struktura a tak dále.
3. Ověření ovlivňujících faktorů tisku pájecí pasty a svařování otvorů reflow
Testy QFN a holých čipů byly použity k potvrzení hlavních příčin vzniku dutin po reflow svařování a k nalezení způsobů, jak zlepšit dutiny po reflow svařování vytištěné pájecí pastou. Profil produktu pro reflow svařování QFN a pájecí pasty s holými čipy je znázorněn na obrázku 4. Velikost svařované plochy QFN je 4,4 mm x 4,1 mm, svařovaná vrstva je pocínovaná (100% čistý cín); Velikost svařované holého čipu je 3,0 mm x 2,3 mm, svařovaná vrstva je naprašovaná bimetalická vrstva nikl-vanad a povrchová vrstva je vanad. Svařovací ploška substrátu byla bezproudová, pozlacená nikl-palladiem, a tloušťka byla 0,4 μm / 0,06 μm / 0,04 μm. Použita je pájecí pasta SAC305, zařízení pro tisk pájecí pasty je DEK Horizon APix, zařízení pro refluxní pec je BTUPyramax150N a rentgenové zařízení je DAGExD7500VR.
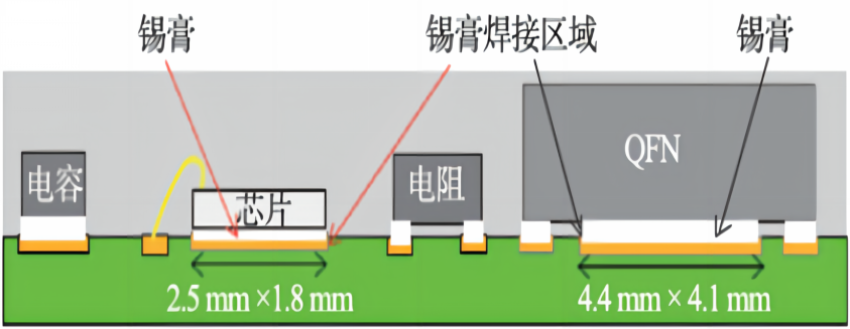
Výkresy svařování QFN a holé třísky
Pro usnadnění porovnání výsledků zkoušek bylo provedeno reflow svařování za podmínek uvedených v tabulce 2.

Tabulka podmínek svařování reflow
Po dokončení povrchové montáže a reflow svařování byla svarová vrstva detekována rentgenem a bylo zjištěno, že ve svarové vrstvě ve spodní části QFN a na holé třísce jsou velké otvory, jak je znázorněno na obrázku 5.
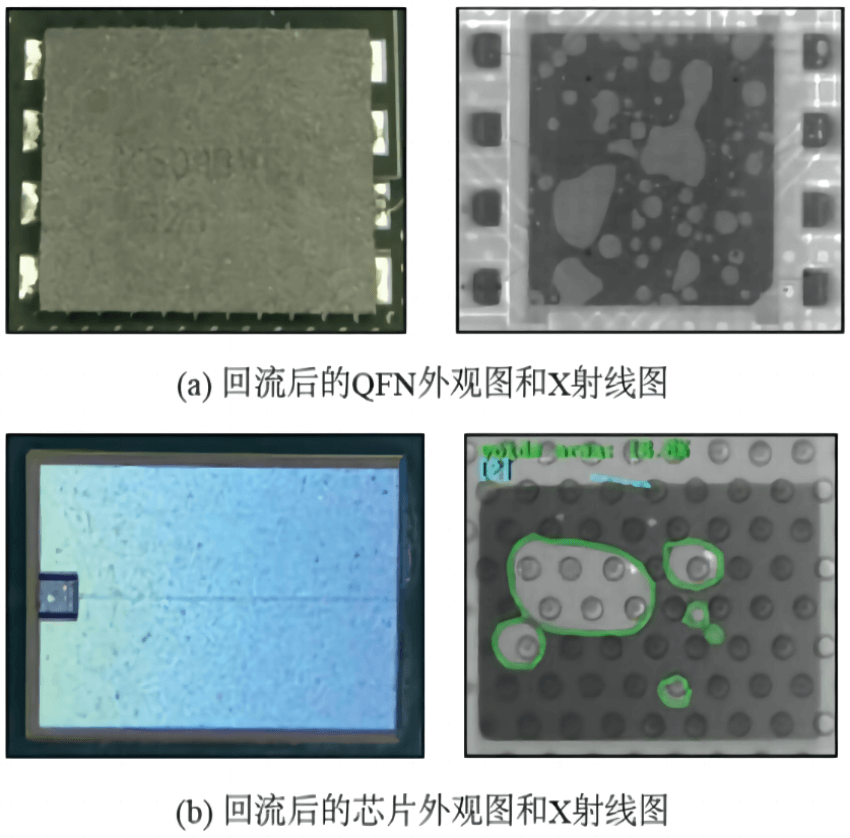
QFN a čipový hologram (rentgen)
Vzhledem k tomu, že velikost cínových kuliček, tloušťka ocelové síťoviny, míra otevření, tvar ocelové síťoviny, doba varu a maximální teplota pece ovlivňují dutiny po reflow svařování, existuje mnoho ovlivňujících faktorů, které budou přímo ověřeny testem DOE, a počet experimentálních skupin bude příliš velký. Je nutné rychle prověřit a určit hlavní ovlivňující faktory pomocí korelačního srovnávacího testu a poté dále optimalizovat hlavní ovlivňující faktory pomocí DOE.
3.1 Rozměry pájecích otvorů a cínových kuliček pájecí pasty
U testu pájecí pasty SAC305 typu 3 (velikost kuliček 25-45 μm) zůstávají ostatní podmínky nezměněny. Po přetavení se změří otvory v pájecí vrstvě a porovnají se s pájecí pastou typu 4. Zjistilo se, že otvory v pájecí vrstvě se mezi oběma druhy pájecí pasty významně neliší, což naznačuje, že pájecí pasta s různou velikostí kuliček nemá žádný zjevný vliv na otvory v pájecí vrstvě, což není ovlivňující faktor, jak je znázorněno na obr. 6.

Porovnání otvorů v kovovém cínovém prášku s různými velikostmi částic
3.2 Tloušťka svařovací dutiny a potištěné ocelové sítě
Po přetavení byla plocha dutiny svařené vrstvy změřena s potištěnou ocelovou sítí o tloušťce 50 μm, 100 μm a 125 μm, přičemž ostatní podmínky zůstaly nezměněny. Bylo zjištěno, že vliv různé tloušťky ocelové sítě (pájecí pasty) na QFN byl porovnán s vlivem potištěné ocelové sítě o tloušťce 75 μm. S rostoucí tloušťkou ocelové sítě se plocha dutiny postupně pomalu zmenšuje. Po dosažení určité tloušťky (100 μm) se plocha dutiny obrátí a začne se zvětšovat se zvětšující se tloušťkou ocelové sítě, jak je znázorněno na obrázku 7.
Z toho vyplývá, že když se zvýší množství pájecí pasty, tekutý cín s refluxem je pokryt čipem a výstup zbytkového vzduchu je úzký pouze na čtyřech stranách. Když se změní množství pájecí pasty, výstup zbytkového vzduchu se také zvýší a okamžitý výbuch vzduchu obaleného tekutým cínem nebo těkavého plynu unikajícího z tekutého cínu způsobí, že tekutý cín rozstříká QFN a čip.
Test zjistil, že se zvětšující se tloušťkou ocelové sítě se zvyšuje i prasknutí bublin způsobené únikem vzduchu nebo těkavých plynů a odpovídajícím způsobem se zvyšuje i pravděpodobnost rozstřikování cínu kolem QFN a třísky.

Porovnání otvorů v ocelové síti různé tloušťky
3.3 Poměr ploch svařovací dutiny a otvoru ocelové sítě
Byla testována potištěná ocelová síťovina s mírou otevírání 100 %, 90 % a 80 %, přičemž ostatní podmínky zůstaly nezměněny. Po přetavení byla změřena plocha dutiny svařené vrstvy a porovnána s potištěnou ocelovou sítí se 100% mírou otevírání. Bylo zjištěno, že za podmínek míry otevírání 100 % a 90 % a 80 % nebyl v dutině svařené vrstvy žádný významný rozdíl, jak je znázorněno na obrázku 8.

Porovnání dutin s různou plochou otvoru u různých ocelových sítí
3.4 Svařená dutina a tvar potištěné ocelové sítě
Při testu tvaru tisku pájecí pasty pásku b a šikmé mřížky c zůstávají ostatní podmínky nezměněny. Po přetavení se změří plocha dutiny svarové vrstvy a porovná se s tvarem tisku mřížky a. Zjistilo se, že za podmínek mřížky, pásku a šikmé mřížky není v dutině svarové vrstvy žádný významný rozdíl, jak je znázorněno na obrázku 9.
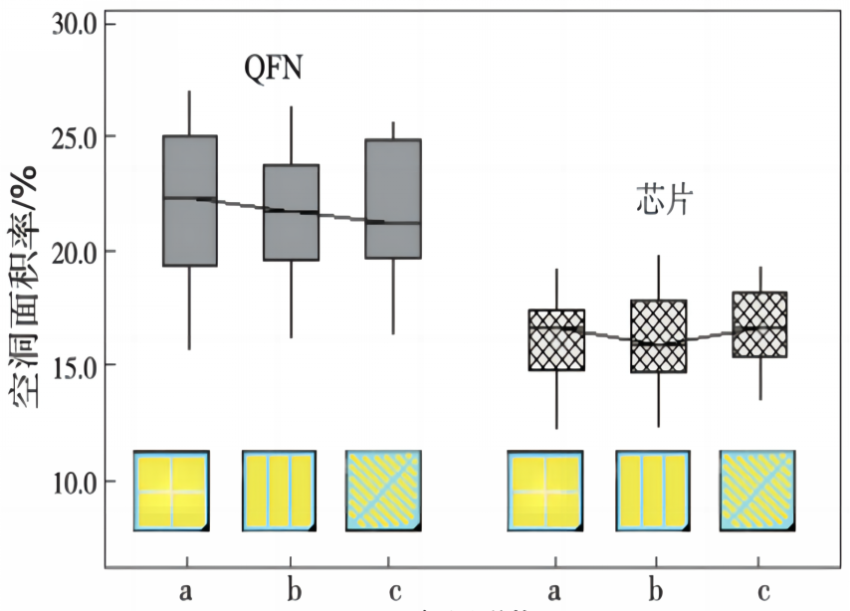
Porovnání otvorů v různých režimech otevírání ocelové sítě
3.5 Svařovací dutina a doba refluxu
Po zkoušce s prodlouženou dobou refluxu (70 s, 80 s, 90 s), přičemž ostatní podmínky zůstaly nezměněny, byl po refluxu změřen otvor ve svarové vrstvě a ve srovnání s dobou refluxu 60 s bylo zjištěno, že se zvyšující se dobou refluxu se plocha svarového otvoru zmenšuje, ale amplituda zmenšení se s prodlužující se dobou postupně snižuje, jak je znázorněno na obrázku 10. To ukazuje, že v případě nedostatečné doby refluxu vede prodloužení doby refluxu k úplnému přetečení vzduchu obaleného roztaveným tekutým cínem, ale po prodloužení doby refluxu na určitou dobu je obtížné vzduch obalený tekutým cínem znovu přetéct. Doba refluxu je jedním z faktorů ovlivňujících svařovací dutinu.

Neplatné srovnání různých délek doby refluxu
3.6 Svařovací dutina a maximální teplota pece
Při testu maximální teploty pece 240 °C a 250 °C a dalších nezměněných podmínkách byla po přetavení změřena plocha dutiny svařené vrstvy a ve srovnání s maximální teplotou pece 260 °C bylo zjištěno, že za různých podmínek maximální teploty pece se dutina svařené vrstvy QFN a třísky významně nezměnila, jak je znázorněno na obrázku 11. Ukazuje se, že různé maximální teploty pece nemají žádný zjevný vliv na QFN a otvor ve svarové vrstvě třísky, což není ovlivňujícím faktorem.

Neplatné srovnání různých maximálních teplot
Výše uvedené testy ukazují, že významnými faktory ovlivňujícími dutinu svarové vrstvy QFN a třísku jsou doba varu a tloušťka ocelové sítě.
4 Zlepšení dutiny pro reflow svařování tiskem pájecí pasty
4.1 Zkouška DOE pro zlepšení svařovací dutiny
Otvor ve svarové vrstvě QFN a třísky byl vylepšen nalezením optimální hodnoty hlavních ovlivňujících faktorů (doba zpětného toku a tloušťka ocelové síťoviny). Použitá pájecí pasta byla SAC305 typu 4, tvar ocelové síťoviny byl mřížkový (100% stupeň otevření), maximální teplota pece byla 260 °C a další zkušební podmínky byly stejné jako u zkušebního zařízení. Test DOE a výsledky jsou uvedeny v tabulce 3. Vliv tloušťky ocelové síťoviny a doby zpětného toku na otvory pro svařování QFN a třísky je znázorněn na obrázku 12. Prostřednictvím interakční analýzy hlavních ovlivňujících faktorů bylo zjištěno, že použití tloušťky ocelové síťoviny 100 μm a doby zpětného toku 80 s může významně zmenšit svarovou dutinu QFN a třísky. Míra svařovací dutiny QFN se snížila z maximálních 27,8 % na 16,1 % a míra svařovací dutiny třísky se snížila z maximálních 20,5 % na 14,5 %.
V testu bylo vyrobeno 1000 produktů za optimálních podmínek (tloušťka ocelové sítě 100 μm, doba varu pod zpětným chladičem 80 s) a náhodně byla měřena míra vzniku svarových dutin u 100 QFN a třísky. Průměrná míra vzniku svarových dutin u QFN byla 16,4 % a průměrná míra vzniku svarových dutin u třísky byla 14,7 %. Míra vzniku svarových dutin u třísky a třísky se zřetelně snížila.

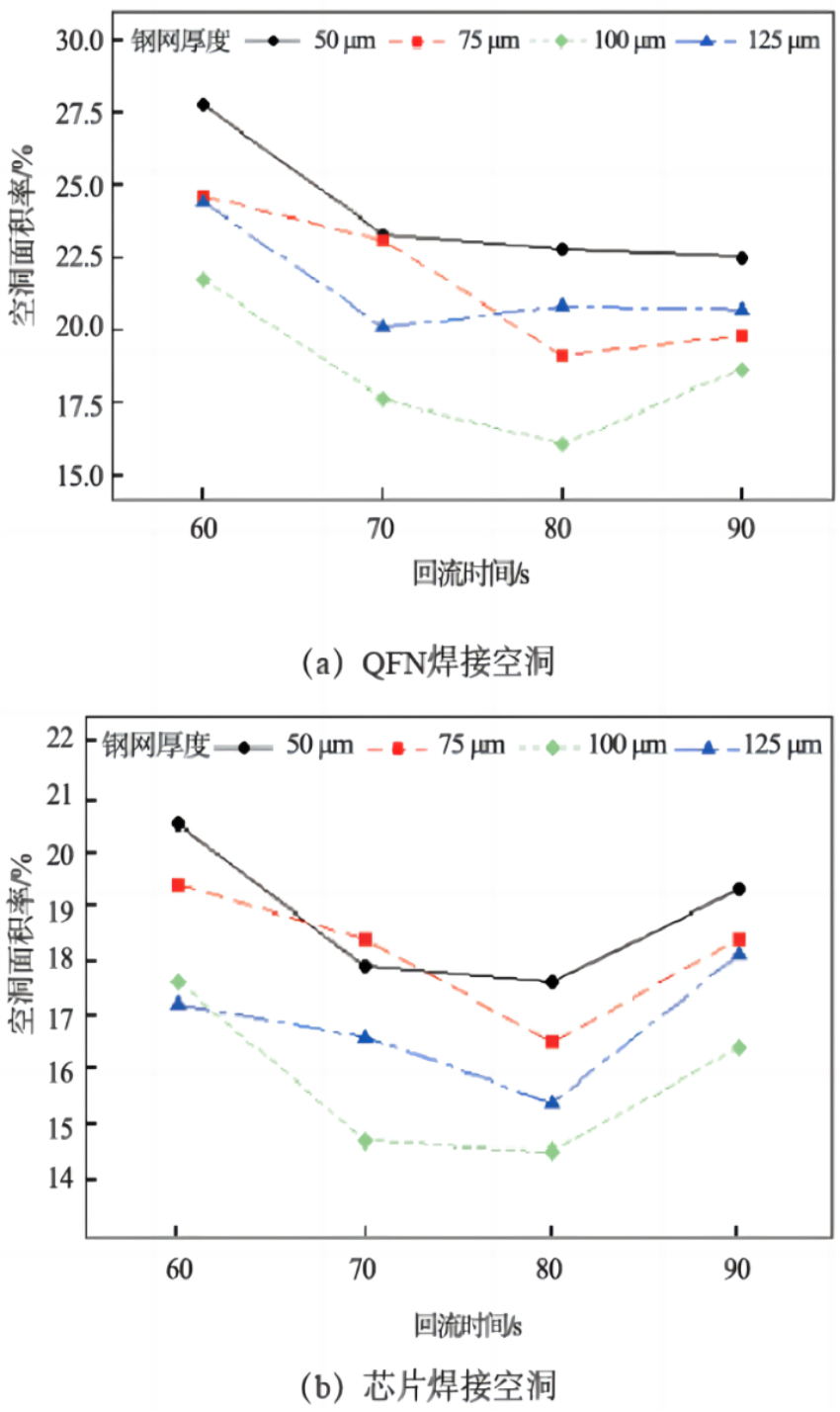
4.2 Nový proces zlepšuje svařovací dutinu
Skutečná výrobní situace a testy ukazují, že pokud je plocha svařovací dutiny ve spodní části čipu menší než 10 %, problém s praskáním v dutině čipu se během spojování a lisování vývodů nevyskytne. Procesní parametry optimalizované ministerstvem energetiky (DOE) nemohou splňovat požadavky na analýzu a řešení otvorů při konvenčním svařování reflow pájecí pastou a je třeba dále snížit plochu svařovací dutiny čipu.
Protože čip pokrytý pájkou zabraňuje úniku plynu z pájky, je počet otvorů ve spodní části čipu dále snížen eliminací nebo snížením množství plynu pokryté pájkou. Byl použit nový proces reflow svařování se dvěma typy tisku pájecí pasty: jeden tisk pájecí pasty, jeden reflow bez pokrytí QFN a holý čip s vypouštěním plynu v pájce. Konkrétní proces sekundárního tisku pájecí pasty, záplatování a sekundárního refluxu je znázorněn na obrázku 13.
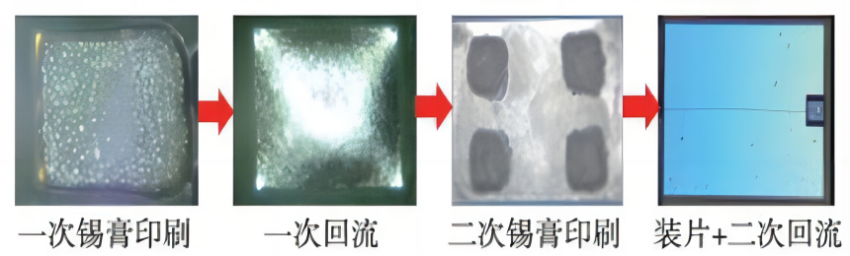
Při prvním tisku pájecí pasty o tloušťce 75 μm uniká většina plynu z pájky bez krytu čipu z povrchu a tloušťka po refluxu je asi 50 μm. Po dokončení primárního refluxu se na povrch ochlazené ztuhlé pájky natisknou malé čtverečky (aby se snížilo množství pájecí pasty, snížilo množství přetékání plynu a snížilo nebo eliminovalo rozstřik pájky) a pájecí pasta o tloušťce 50 μm (výše uvedené výsledky testů ukazují, že 100 μm je nejlepší, takže tloušťka sekundárního tisku je 100 μm. 50 μm = 50 μm), poté se nainstaluje čip a poté se po 80 sekundách vrátí zpět. Po prvním tisku a přetavení v pájce téměř nezůstane žádný otvor a pájecí pasta při druhém tisku je malá a svařovací otvor je malý, jak je znázorněno na obrázku 14.
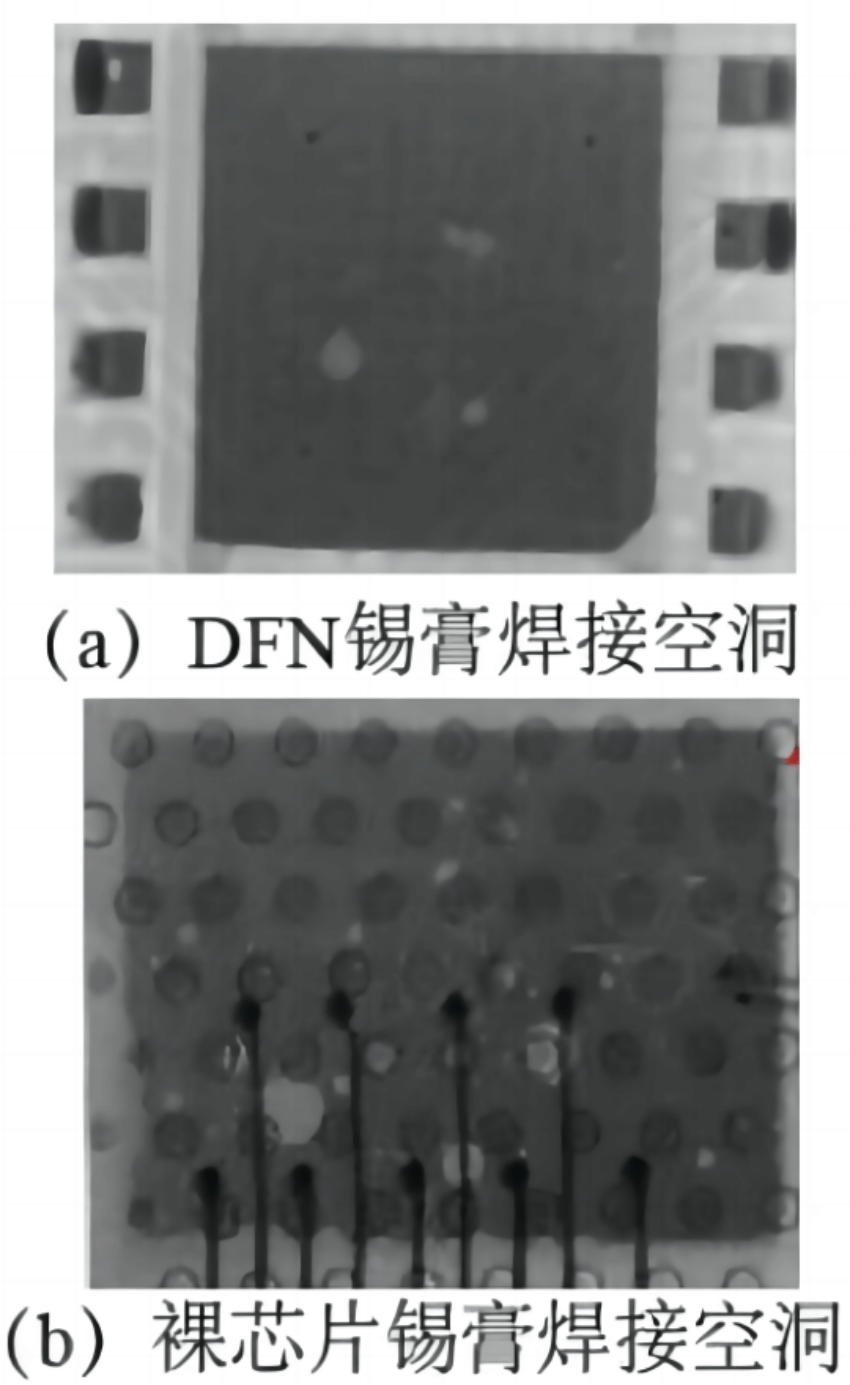
Po dvou výtiscích pájecí pasty, dutý výkres
4.3 Ověření vlivu svařovací dutiny
Výroba 2000 produktů (tloušťka první tiskové ocelové sítě je 75 μm, tloušťka druhé tiskové ocelové sítě je 50 μm), ostatní podmínky nezměněny, náhodné měření 500 QFN a míry svařování třísek zjistilo, že nový proces po prvním refluxu bez dutiny, po druhém refluxu QFN je maximální míra svařování třísek 4,8 % a maximální míra svařování třísek je 4,1 %. Ve srovnání s původním procesem svařování s jednou pastou a procesem optimalizovaným DOE je svařování třísek výrazně menší, jak je znázorněno na obrázku 15. Po funkčních testech všech produktů nebyly zjištěny žádné praskliny ve třískách.

5 Shrnutí
Optimalizace množství nanášené pájecí pasty a doby refluxu může zmenšit plochu svařovací dutiny, ale míra svařovací dutiny je stále velká. Použití dvou technik tisku pájecí pasty a reflow svařování může efektivně maximalizovat míru svařovací dutiny. Svařovací plocha holého čipu QFN obvodu může být v hromadné výrobě 4,4 mm x 4,1 mm, respektive 3,0 mm x 2,3 mm. Míra svařování reflow je udržována pod 5 %, což zlepšuje kvalitu a spolehlivost reflow svařování. Výzkum v tomto článku poskytuje důležitý referenční bod pro zlepšení problému svařovacích dutin s velkou plochou svařovaného povrchu.






